Kode QR

Babagan Kita
Produk
Hubungi Kita


Fax
+86-579-87223657

E-mail

alamat
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, China
Polishing mekanik kimia (CMP) ngilangi materi lan permukaan permukaan sing berlebihan liwat tumindak gabungan reaksi kimia lan abrasi mekanik. Minangka proses utama kanggo entuk planarization global saka permukaan wafer lan ora pati penting kanggo sinkronnents tembaga multilayer lan struktur dieleckrik renda. Ing manufaktur praktis, CMM ora proses mbusak seragam sing sampurna; Menehi cacat pola pola pola, ing antarane nyembur lan erosi sing paling penting. Bateni kasebut langsung mengaruhi geometri lapisan sinkronconnect lan karakteristik listrik.
Dolking nuduhake penghapusan bahan-bahan sing berlebihan saka bahan-bahan konduktivitas sing berlebihan (kayata tembaga) sajrone CMM, sing ndadékaké profil cermin berbentuk sajian ing njero garis logam siji utawa area logam sing gedhe. Ing sambungan-section, pusat logam ana luwih murah tinimbang rong sudhut lan permukaan dielektrik. Fenomena iki asring diamati ing garis, bantalan, utawa wilayah logam jinis blok. Mekanisme formasi utamane ana gandhengane karo beda karo kekerasan material lan ubahane pad polish ing sisih logam sing luwih sensitif, nyebabake tingkat penghubung ing tengah logam kanggo ngluwihi ing sudhut. Akibaté, ambane piring biasane mundhak kanthi jembar lan wektu gedhe.
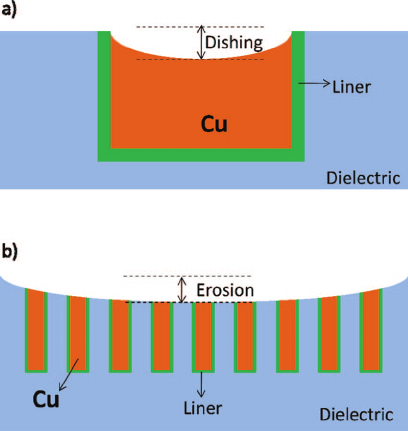
Erosi ditondoi dening dhuwur permukaan sakabehe ing wilayah kapadhetan sing dhuwur (kayata garis-garis utawa wilayah logam logam sing padhet utawa wilayah sing dikebuh) luwih murah tinimbang ing wilayah kasebut sawise CMP. Intine, iku minangka pola sing didorong, tingkat tingkat wilayah tingkat. Ing wilayah sing padhet, logam lan dielektrik bebarengan nyedhiyakake area kontak sing efektif, lan gesekan mekanik lan tumindak kimia pad lan slurry luwih kuat. Akibate, tarif aman saka logam lan dielektrik luwih dhuwur tinimbang ing wilayah kapadhetan. Minangka polishing lan tumpukan polishing, tumpukan dielektrik logam ing wilayah sing kandhel dadi luwih tipis, dadi langkah erosi kanthi pola pola lan proses loading lokal.
Saka perspektif piranti lan proses proses, nyusoni lan erosi duwe macem-macem pengaruh gedhe ing produk semikonduktor. Nyuda nyuda area salib-bagean saka logam, sing ndadékaké resistensi interconnect sing luwih dhuwur lan irit, sing bakal nundha signal tundha lan nyuda wates wektu kanggo jalur kritis. Variasi ing ketebalan dielektrik sing disebabake erosi ngganti kapasitas parasit antarane garis logam lan distribusi tundha rc, ngrusak keseragaman saka cracter listrik ing chip. Kajaba iku, konsentrasi bidang lokal lan konsentrasi lapangan listrik lokal mengaruhi prilaku pecah lan linuwih jangka panjang saka dielelektrik antar logam. Ing tingkat integrasi, topografi permukaan sing berlebihan nambah kesulitan fokus lan alignment, ngrusak keseragaman pendeposisi sakteruse lan bisa nyebabake cacat logam. Masalah kasebut pungkasane nyata minangka asil fluktuasi lan jendhela proses nyusut. Mula, ing teknik praktis, perlu kanggo ngontrol piring lan ugingan ing watesan sing ditemtokake liwat perjogen tata letak, optimasi sakaPolishing sLurusPilihan, lan tuning paramèter proses CMP, saéngga kanggo mesthekake struktur sinkterconnect, kinerja listrik sing stabil, lan manufaktur volume dhuwur.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, China
Hak Cipta © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Kabeh hak dilindhungi undhang-undhang.
Links | Sitemap | RSS | XML | Kebijakan Privasi |
